CSP(Chip Size Package或Chip Scale Package)称为芯片尺寸封装,目前尚无确切定义,JEDEC给出的标准规定:LSI芯片封装面积小于或等于LSI裸芯片面积120%的产品称为CSP,制备CSP芯片的技术称CSP技术。
CSP封装具有 1、体积小、单位面积容纳引脚数多 2、电性能良好内部布线长度远短于QFP和BGA 3、测试、筛选、老化容易 4、散热性能优良芯片面朝下安装,能从背面散热 5、无需内填料,不必进行下填充工艺 6、制造工艺、设备兼容性好 在便携式、低引脚数和低功率产品中应用广泛,主要用于闪存、RAM、DRAM存储器等产品中。目前,超过100家公司开发CSP产品:Amkor、Tessera、Chip-scale、Sharp等,市场潜力巨大。 存在的问题: 1、标准化-市场准入机制 2、可靠性-系统可靠性要求高,可返修性及返修成本高。 3、成本-价格影响市场竞争力
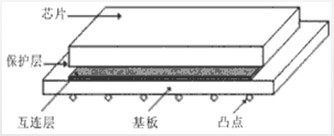
CSP是BGA进一步微型化的产物,又称uBGA,按结构可分柔性基板封装CSP、刚性基板封装CSP、引线框架式CSP、晶圆级CSP以及薄膜型CSP等。
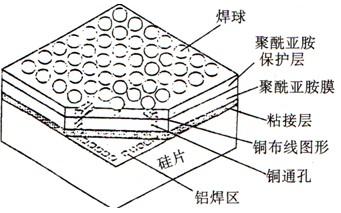
此封装类型由美国Tessra公司首次开发,日本NEC公司开发的FPBGA(细间距BGA)属于此类型,采用PI或类似材料作垫片,内层互连采用TAB、FC或WB方式。互连层在垫片的一个面,焊球穿过保护层与互连层相连。
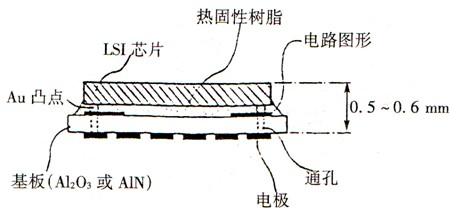
此封装类型由日本Toshiba公司首次开发,与柔性基板封装不同之处在于刚性垫片是通过多层陶瓷叠加或经通孔与外层焊球相连。采用的键合方式为FC和WB。
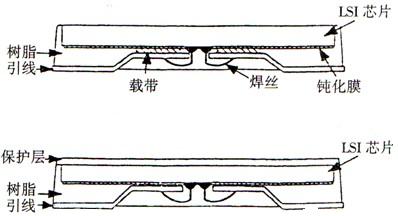
此封装类型由日本Fujitsu公司首次开发,引线框架常由金属材料制作,互连通过外引线框架实现。该类型封装与传统的塑封工艺完全相同,只是采用的框架小一些、薄一些。键合方式为TAB、FCB及WB。
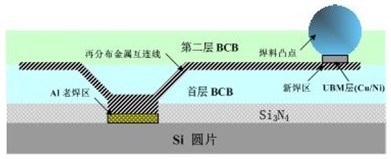
此封装类型由Chip-scale公司首次开发,是在晶圆阶段利用芯片较宽的划片槽,在周边构造互连,随后用玻璃、树脂等材料进行封装完成。
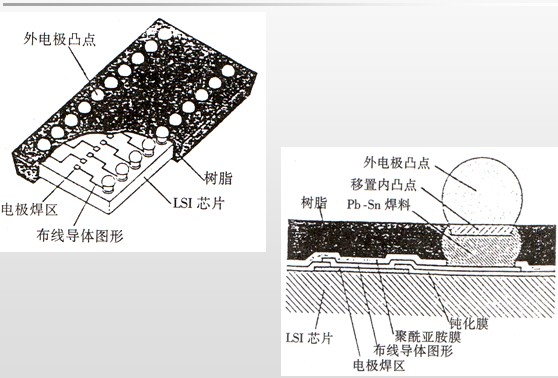
此类型由日本三菱公司首次开发,主要结构是L封装SI芯片、模塑树脂和焊料凸点。此封装无引线框架键合线,易于实现小型化和薄型化。
制作过程在半导体制造后工程中进行,采用薄膜工艺形成金属布线图形和焊盘,采用PI作为缓冲膜材料。
维库电子通,电子知识,一查百通!
已收录词条45426个