硅外延片在硅单晶衬底上沿其原来的晶向再生长一层硅单晶薄膜的半导体硅材料。严格的说是在N型硅抛光片衬底上生长的N型外延层(N/N+)和在P型硅抛光片衬底上生长的P型外延层(P/P+)的同质硅外延片。产品用于制作半导体器件。
硅外延已发展成为门类繁多的技术,从外延层在器件制造中的作用看,可分为正外延和反外延。器件直接制作在外延层上的叫正外延;器件制作在348单晶衬底上,外延层作为基底,叫反外延。从化学组成看,可分为同质外延和异质外延。外延层和衬底属同一种物质,称同质外延,外延层和衬底不属同种物质,称异质外延。制备硅外延片的方法有气相外延、液相外延、分子束外延等。其中以化学气相淀积(CVD)为基础的气相外延是现在生产硅外延的主流。常用的源有SiCl4 、SiHCl3、SiH2Cl2和SiH44种。目前以SiCl4源应用最广泛。对于亚微米级外延,从低温看,硅烷似乎比其他源好,但硅烷在极少量空气存在下会在硅外延层中产生SiO2微粒,SiH2Cl2用于优质外延及薄层外延。
1 导电类型
产品按导电类型分为N型和P型。
2 规格
产品按直径尺寸分为76.2mm、100mm、125mm和150mm
3 外延片晶向
产品按晶向分为<111>、<100>等
以SiCl4为源的气相外延法为例。将硅单晶衬底加热到1200℃左右,将含有SiCl4蒸汽的氢气流过衬底表面。利用化学反应SiCl4+2H2=Si↓+4HCl↑,氢和四氯化硅在衬底表面或附近发生反应,生成游离状态的硅原子和副产物HCl。后者随着主气流被排走。而游离状态的硅原子经表面和台阶扩散,坐落在晶格格点上,释放潜热,成为晶相原子,实现外延生长。实际上此过程远比上述反应复杂,还有许多其他中间产物生成。当气流与基座(包括衬底硅片)接触时,形成边界层,反应剂以及掺杂剂要扩散通过此边界层到达生长层,反应副产物也要扩散通过此边界层返回到主流区。边界层厚度对气流速度很敏感。设计反应器和制定工艺条件时,必须考虑边界层厚度对输运过程的影响。应当调整边界层厚度,以获得均匀的外延层。作为外延衬底的硅抛光片要在反应器内通入HCL气体,于外延沉积前进行气相腐蚀以消除衬底表面的损伤和污染。掺杂是使用气相掺杂法,掺杂剂为硼、磷、砷的卤化物或氢化物,现在多用氢化物如B2H6,PH3,AsH3等。
硅外延所用设备见图,主要由反应器、加热装置、气体控制系统和氢气净化装置组成。
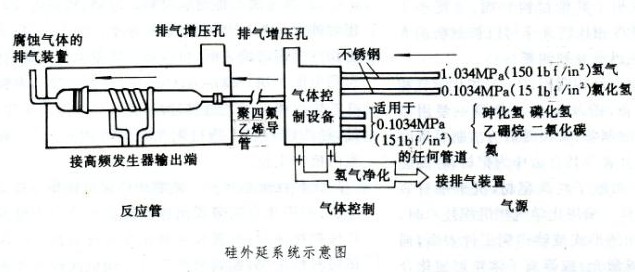
反应器 一般为石英制品,其结构形成由最初的卧式逐渐发展为立式和桶式3种。卧式为水平放置的石英管,现多为矩形管以改善均匀性;放置衬底的包覆了碳化硅的石墨基座相对气流有3。~5。的倾斜,以利于改善均匀性。为进一步提高外延层的均匀性,便出现了立式反应器,其大多为钟罩形,基座是水平放置的并可转动的圆盘,反应气流与基座表面垂直,外延层表面易受反应气流中颗粒的撞击和玷污。因此,卧式反应器便略占优势。为结合卧式和立式二者的优点,便有为人们所乐意使用的桶式反应器,其外形与立式相仿,但基座为可转动的直立柱体,其气流平行于基座柱体表面。反应器结构是影响外延层均匀性和质量的重要因素。
加热装置 大多采用高频感应加热方式,间接地加热衬底。为使加热均匀,高频加热线圈和基座的结构形状以及相互间的匹配是十分重要的。因高频感应加热是通过基座背面进行的,基座和硅片间有温度差,容易使硅片翘曲,引起位错和滑移应力,为克服此缺点,后来便有红外辐射加热的出现,并已使用于工业化生产的外延设备中。
气体控制系统 是由各种阀门、流量计和耐腐蚀材料制的相连接所组成的密封不漏气的系统。它对各种气体的流量进行精密的控制和调节。所用的阀门从最原始的玻璃考虑到后来采用的不锈钢阀、电磁阀;管道也由原先的塑料管、玻璃管、石英管等被当前广泛采用的不锈钢管所代替;流量计也由一般的转子流量计发展到普遍使用质量流量计;反应气体组分也由手工操作调节为自动控制所取代。
氢气净化装置 是以各种吸附剂或钯管对氢气进行净化以达到所需纯度。为获得质量优良、重现性好的硅外延片,现代的硅外延设备已能对整个外延全过程实现自动化程序控制。
质量控制 硅外延片质量直接影响到器件性能。SiCl4硅外延是一个高温可逆反应的过程,衬底中的杂质通过扩散、蒸发、自掺杂等效应,加之气没能及时迅速地排出而造成外延层的不均匀。采用SiH2Cl2和SiH4作为硅源,使反应温度降低;采用减压外延,将反应器一边抽空、一边控制通入反应器的气体流量,使反应器内的压力在8~20kPa的低压下,杂质分子、腐蚀性气体便能迅速随主气流排走,从而抑制上述多种效应。硅外延层的缺陷有许多种,如层错、位错等晶格缺陷和划痕、亮点、角锥、雾状等表面形貌缺陷。衬底制备质量、加热方式、生长速度、气氛和试剂纯度、反应室结构以及气相腐蚀等都对缺陷产生相应的影响。
自50年代末,硅外延片成功地应用于制造高频大功率晶体管,并显示出其巨大的优越性后,其用途越来越广。在双极型器件中,不论是晶体管、功率管还是线性集成电路和数字集成电路的制造,都离不开使用硅外延片。对MOS器件而言,虽则较晚使用硅外延片,但由于在解决CMOS电路中闩锁(Latch-up)效应,硅外延片得到广泛的应用。当前BiCMOS电路也都采用硅外延片来制造。一部分电荷耦合器件(CCD)已使用外延片制作。
为了满足各种半导体器件的需要,相应地也产生了各样的硅外延技术。除上述提到的低温外延、减压外延外,还有在硅片的特定部位沉积硅外延层的选择性外延。它是在硅衬底上先沉积一层二氧化硅,经光刻在所需部位开“外延窗口”,然后进行外延生长。为满足某些半导体器件要求有很高电阻率的外延层,而产生的高阻外延技术等。
维库电子通,电子知识,一查百通!
已收录词条45468个