TSOP封装,即薄型小尺寸封装,英文为Thin Small Outline Package,是显存颗粒封装的主流。TSOP内存封装技术的一个典型特征就是在封装芯片的周围做出引脚,采用SMT技术(表面安装技术)直接附着在PCB板的表面。

上世纪80年代,芯片的TSOP封装技术出现,得到了业界广泛的认可。TSOP封装有一个非常明显的特点,就是成品成细条状长宽比约为2:1,而且只有两面有脚,适合用SMT技术(表面安装技术)在PCB(印制电路板)上安装布线。TSOP封装外形尺寸时,寄生参数(电流大幅度变化时,引起输出电压扰动) 减小,适合高频应用,操作比较方便,可靠性也比较高,同时TSOP封装具有技术简单、成品率高、造价低廉等优点,因此得到了极为广泛的应用。
TSOP可以通过SMD制作成SD卡、MiniSD卡、CF卡或是集成到MP3/MP4、移动存储器等不同的终端产品中,具有柔韧性。TSOP封装方式中,内存芯片是通过芯片引脚焊接在PCB板上的,焊点和PCB板的接触面积较小,使得芯片向PCB板传热就相对困难。而且TSOP封装方式的内存在超过150MHz后,会产生较大的信号干扰和电磁干扰。
单芯片TSOP生产工艺流程比较简单,只需要经过一次贴片、一次烘烤、一次引线键合就可以了,流程如图1:

我们可以根据封装名称来识别叠层芯片封装中有多少个芯片。比如,“TSOP2+1”就是指一个TSOP封装体内有两个活性芯片(ActiveDie)、一个空白芯片(Spacer),如果我们说“TSOP3+0”,那就是说一个TSOP封装体内有三个活性芯片、没有空白芯片,以此类推。
图2是最典型的TSOP2+1的封装形式剖面和俯视图,上下两层是真正起作用的芯片(ActiveDie),中间一层是为了要给底层芯片留出焊接空间而加入的空白芯片(Spacer)。空白芯片(Spacer)由硅片制成,里面没有电路。

我们以最简单的二芯片叠层封装(TSOP2+X)为例查看其工艺流程:
方法一,仍然沿用单芯片封装的液态环氧树脂作为芯片粘合剂、多次重复单芯片的工艺,其工艺流程如下:

方法二,使用环氧树脂薄膜作为芯片贴合剂。这种方法需要改变原材料,用环氧树脂薄膜胶带替代传统的蓝膜(如SPV224)。下图是使用环氧树脂薄膜胶替代蓝膜后装片工序的情形,装片完成后,环氧树脂薄膜就已经和芯片粘在了一起,在贴片工序时我们只需要将芯片贴到引线框架上,不再需要在引线框架涂一层液态环氧树脂,这就大大简化了工艺。工艺流程如下:
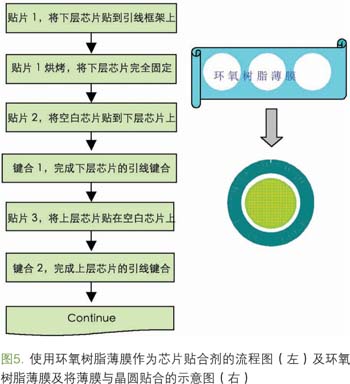
采用上述两种方法来实现TSOP2+1封装都是可行的。对比以上两种工艺,我们可以发现第二种工艺流程少了两次烘烤,方法二生产工艺简单、生产周期更短,而且,由于多次烘烤会造成引线框架氧化及芯片粘污,烘烤次数减少对提高成品率和减少可靠性失效也很有好处。

将方法二简化,于是就得到了另一种实现两层芯片叠层封装的方法,即TSOP2+0,采用环氧树脂薄膜作为芯片贴合剂,将两个芯片错开一点位置留出焊区域,仅一端有焊线。
方法三,如果我们使用的设备可以同时完成多次贴片,那么实际的贴片工序就更加简单,即只有一次,这样它的生产工艺甚至比单芯片封装还简单。但是这种方法需要改变晶圆的生产工艺,将焊盘都放置在芯片的一端。

上述三种叠层芯片的封装工艺,方法一使用环氧树脂银浆,成本低,但是工艺难度很高、成品率低,即使是最简单的TSOP2+1其成品率能达到99.5%就几乎不可能再提升了,由于其工艺性差,目前不能使用在更高密度的封装中。方法二中虽然环氧树脂薄膜成本高,但是由于环氧树脂薄膜是在装片(W/M)的时候粘贴到芯片背面,不必考虑液态环氧树脂工艺的复杂性,所以工艺简单、成品率可达99.9%。方法三由于只有两次贴片(D/A)、一次引线键合(W/B),所以不仅工艺简单、成品率高,可以稳定在99.90%以上,而且成本相对也比较低。如果我们将成品率与成本相结合,的方法显然是第三种,成本、工艺最简单。但是,这种工艺有其局限性,需要改变芯片的制作布局,将焊盘布置在芯片的一端,如果晶圆的布线无法做到,则无法实现。
第二、第三种方法都可以用于更高密度的封装中,TSOP4+0、TSOP5+0、TSOP4+3等都是在TSOP2+X基础上发展起来的。
叠层芯片封装是封装技术发展的主流,因为它符合了封装技术发展的趋势即:大容量、高密度、多功能、低成本。和过去单芯片封装技术相比,它打破了单纯以封装类型的更替来实现大容量、高密度、多功能、低成本的限制,而且,由于叠层技术的出现,它让一些似乎已经过时的封装类型重新焕发生机。
2006年对于TSOP封装来讲是非常重要的一年。由于TSOP封装的容积率和运行速度不及BGA封装,这种曾经广泛应用于DRAM的封装类型在DDR/DDRII中已经消失。但是随着数码产品的大量普及,人们对大容量、高密度、低成本的存储卡的需求激增,它已经成了仅次于SIP的NAND存储器的封装类型。
在TSOP的封装技术发展方面,主要有TSOP2+0、TSOP2+1、TSOP3+0、TSOP4+0、TSOP5+0、TSOP4+3等,其技术已经非常成熟、成品率高。由于芯片面积越来越大,为了解决焊接空间的不足,一些在SIP封装中得到应用的新技术也将开始出现在TSOP高密度封装中。为了解决由于SIP的柔韧性不足的问题,TSOPSIP也会成为另一发展方向。
维库电子通,电子知识,一查百通!
已收录词条45650个